一、服务推介:
1.1 晶圆级芯片尺寸封装(WL-CSP):
1.1.1 WL-CSP之简介:
CSP(Chip Scale Packaging)并没有一个全球统一的定义或标准,目前CSP大约是指封装产品的面积只比晶粒面积多20%以内,而封装产品的接脚间距(pitch)在1.0
mm以下者。CSP的崛起,要归功于可携式电子产品外型尺寸不断地缩小,同时半导体及消费性电子领导厂商如英特尔、NEC、富士通、夏普、SONY等纷纷在其新产品上采用CSP型态的封装、更带动其它厂商跟进之风。
行动电话是当前牵动CSP市场急速成长的主因,采用CSP可以让封装面积缩减到用TSOP时的四分之一到十分之一,非常适合作为行动电话用大容量型闪存的封装,此外,手持摄影机、PDA等重视产品尺寸的新兴产品,日本厂商亦以CSP封装型态为优先考量。
何谓WLCSP,它的全名是Wafer Level Chip Scale Packaging,此种技术已跳脱传统作法,不需要打线机、封模机及制具等且更不需要金属脚架与基板等材料,而它的制程更是包括前段芯圆厂的技术(涂布、曝光、显影、溅渡、蚀刻)与PCB板厂的技术(电镀、印刷、植球等)。此种封装技术的IC主要优点为:体机小(Real
Chip Size)、成本低、制程时间短、材料及治具简单,针对低脚数(约200 Pins以内)的产品皆适合。主要适合产品为记忆体IC可携式的消费性电子产品如:摄录放影机、行动电话、数字相机、携带式影音设备、掌上型计算机、笔记本计算机等。
1.1.2 WLCSP生产线建立
ACE与APiA合作设置一条月产能20K WLSCP的生产线。将于年底开始展开各设备装机。各项设备(与APiA合作)将包括Spin
Coater、Develop、Sputter、Stepper、RIE( Plasma etch)、 Plating、Stripper、UBM
etch、Ball placement cluster 等等 及还包括切割、研磨、晶粒挑检等设备。预计将于明年Q1完成装机与试产。
1.1.3 WLCSP的产能计划
本公司初期2007/Q2,WLCSP月产能以20K W(每月产出20000芯片),到2008/Q4将会扩充到60K的月产能。
--------------------------------------------------------------------------
1.2 晶圆及成品测试:
1.2.1 测试服务:
本公司提供一条龙之测试服务从产品设计、晶圆测试、晶圆级封装、成品测试、SMT表面黏着,甚至也可依客户之要求将委测之产品送达客户指定的地点,一来可减少客户的困扰同时也满足客户的需求.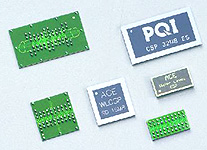
1.2.2 测试之产能:
本公司预计于2007年底进行成品测试之小量试产,可提供DRAM / SRAM产品,月产能3,000,000颗,FLASH月产2,000,000颗,并于2008年第一季进行量产.第一期之产能规划为月产DRAM
/ SRAM 20,000片芯片,产品颗粒月产8,000,000颗, FLASH月产5,000,000颗,如以本公司所专注生产之晶圆级封装技术(WLCSP)将可达到月产12,000,000颗颗粒.且本公司预计于2008年年底月产能将达60,000片芯片.36,000,000颗颗粒.年产量将达720,000片芯片,颗粒产量达四亿三千二百万颗.
|



